Crystalline Silicon/Perovskite PL/EL Integrated Tester
SC-PLEL-PS


Product introduction
Crystalline Silicon/Perovskite PLEL All-in-One System SC-PLEL-PS
Integrated EL and PL dual-mode luminescence inspection, covering crystalline silicon/perovskite/tandem cells, from R&D to mass production throughout the entire lifecycle.
China's First Dual-Mode All-in-One System
Crystalline Silicon/Perovskite PLEL All-in-One System is an innovative inspection device independently developed by Vision Potential. It integrates EL and PL dual-mode luminescence imaging capabilities, enabling synchronous benchmarking analysis of the same detection area and fully presenting the morphology and distribution of various defects. The device is equipped with a highly stable semiconductor laser light source (main wavelength 808±5nm, optional multi-band), paired with a high-sensitivity NIR camera, achieving high-resolution imaging of ≥0.1mm/pixel.
Covers crystalline silicon cells (PERC/TOPCon/HJT/xBC), single-junction perovskite cells, and tandem cells, supporting raw material control, process monitoring, finished product grading, and R&D innovation, providing quantitative data support for photovoltaic technology iteration.
 SC-PLEL-PS Device Diagram
SC-PLEL-PS Device Diagram1000×900×1600mm | Approx. 200kg
Applications

Crystalline Silicon PERC/TOPCon/HJT/xBC

Single-Junction/Flexible Perovskite
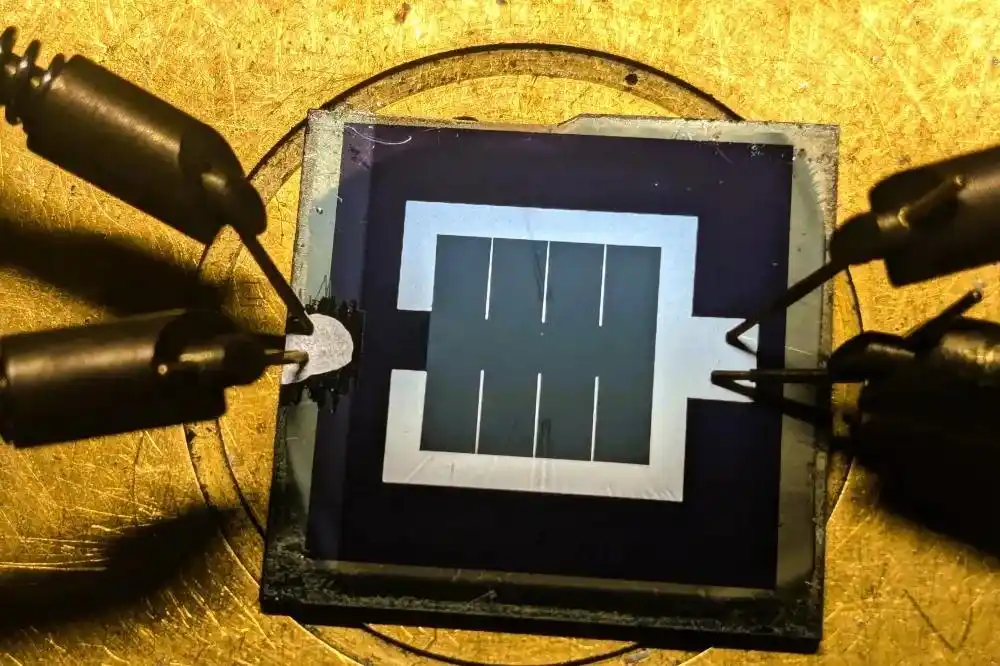
Crystalline Silicon-Perovskite Tandem
01
Raw Material Quality Control
Analyze crystal structure and impurity distribution via PL, eliminate defects at the source, and reduce rework costs.
02
Full-Process Process Monitoring
Capture defects caused by process fluctuations, provide quantitative data to support parameter adjustments, and ensure stable product quality.
03
Finished Product Inspection & Grading
Comprehensively inspect defects and evaluate performance, achieve product grading, ensure compliance with industry standards, and avoid downstream application risks.
04
R&D Innovation Support
Provide quantitative data for high-efficiency cell technology iteration and defect mechanism research, accelerating new technology industrialization.
Functions
Functional Advantages
A1
Dual-Mode Imaging · Synchronous Analysis
EL locks onto current blocking areas caused by cracks; PL identifies non-radiative recombination centers at grain boundaries, fully presenting defect morphology and distribution.
A2
Automated Control
Intelligent control of cylinders/motors for automatic transport, position calibration, and lifting, significantly enhancing inspection efficiency and result repeatability.
A3
Multi-Wavelength Light Source
808±5nm standard, optional 450/915/980nm; spot uniformity ≥90%, power adjustable 0.1~2 suns, precisely matching various cell excitation requirements.
A4
High-Resolution Imaging
NIR-enhanced camera, max frame rate 4.5FPS, imaging accuracy ≥0.1mm/pixel, capturing subtle defects.
A5
Quantitative Parameter Analysis
Proprietary algorithms analyze minority carrier diffusion length, lifetime (accuracy ±0.1μs, τ≤10μs), outputting IVoc, Jo, τ, Rs Mapping.
A6
High-Precision Programmable Power Supply
Constant current/voltage dual modes, voltage 030V (±1%), current 010A (±1%), precisely meeting different cell bias requirements.
Inspection Efficiency: ≤15 seconds per piece, suitable for full-process quality control in industrial mass production, quickly screening unqualified products and reducing subsequent packaging costs.
Auxiliary Functions · Intelligent Analysis Software
· Image Processing: Multiple adjustment methods and format saving
· Data Management: Automatic report generation and traceability
· Precise Observation: Cursor tracking and local statistics
· Intelligent Analysis: Automatic defect classification, MES interface
· Generate Mapping Graphs: IVoc, Jo, τ, Rs, etc.
· From Qualitative to Quantitative: Intuitive performance distribution display
· Suns-Voc Analysis, recombination study
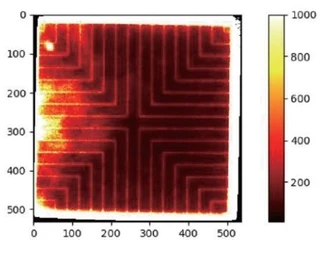

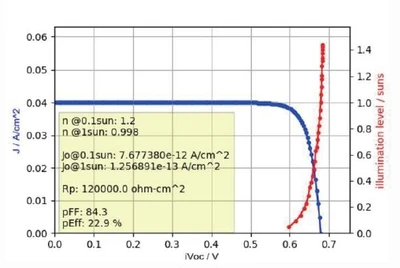
Core Technical Parameters
Parameter Specification Model SC-PLEL-PS Camera Specifications NIR enhanced, 25MP, exposure 10μs~30s, response 400-1200nm Infrared Pixels 500~2500万像素 Lens Specifications HD wide-angle 8/16/25mm optional, FOV ≥80° Light Source Specifications Semiconductor laser, main wavelength 808±5nm (optional 450/915/980nm) Spot Uniformity ≥90% (within effective detection area) Detection Cycle 12μs~10000ms, step 1ms adjustable Detection Wavelength Range 9001300nm (Crystalline Si), 700900nm (Perovskite) Detectable Defect Types Cracks, broken grid, fragments, scratches, cold solder, over-etching, black spots, concentric circles, low-efficiency cells, contamination, etc. Probe Configuration 2~6 sets of pins, adjustable pitch, pure copper gold-plated (customizable) Stage Size 50×50mm ~ 230×230mm (larger customizable) Control Method Proprietary software fully automated control Detection Accuracy Crack width > 50μm detectable Imaging Accuracy ≥0.1mm/pixel Focus Mode / Distance Manual focus / 130-650mm Hardware Mount Aluminum profile, sheet metal, etc. Inspection Time 0.1s~10s (automatic based on object) Test Platform Windows platform Constant Current/Voltage 010A adjustable, accuracy ±1% / 030V adjustable, accuracy ±1% Power 1000-2000W Power Supply Protection Reverse current, overload, leakage, ESD, overheat protection Computing Device Industrial computer Inspection Objects Crystalline Si cells, single-junction Perovskite cells, Crystalline Si-Perovskite tandem cells (bare, with film, packaged) Ambient Temperature 15-50℃, Humidity 30%-70% (non-condensing) Equipment Weight Approx. 200kg (actual product prevails) Dimensions 1000×900×1600mm (L×W×H, actual product prevails) Power Supply Single-phase AC220V±10%, 50HZ±1HZ Application Cases · Multi-Material Imaging Comparison
Inspection Type Inspection Object B&W Imaging False Color Imaging Imaging Analysis PL (Photoluminescence) Crystalline Silicon Cell PL-image-01 PL-image-02 Evaluate crystal quality and carrier lifetime via PL signal intensity: bright areas indicate good crystallization and long lifetime, dark lines/areas indicate cracks, metal impurities, etc. Perovskite Cell PL-image-03 PL-image-04 Analyze film uniformity and defect state density: dark spots correspond to defect-rich areas or interface recombination centers. Perovskite Tandem - Perovskite Layer PL-image-05 PL-image-06 Focus on intrinsic properties and interface matching of the perovskite layer; abnormal luminescence decay indicates high interface state density. Perovskite Tandem - Crystalline Si Layer PL-image-07 PL-image-08 Targeted detection of cracks, contamination in the crystalline Si layer, quantify carrier lifetime, assess tandem structure impact. EL (Electroluminescence) Crystalline Silicon Cell EL-image-01 EL-image-02 Identify electrode contact abnormalities and carrier transport; dark areas may indicate cracks or broken grid. Perovskite Cell EL-image-03 EL-image-04 Identify defect types and current distribution uniformity; dark spots indicate scribing deviations, cracks, or bad cells. Perovskite Tandem - Perovskite Layer EL-image-05 EL-image-06 Evaluate interlayer compatibility and current matching; abnormal luminescence indicates carrier injection/extraction obstacles. Perovskite Tandem - Crystalline Si Layer EL-image-07 EL-image-08 Analyze crystalline Si layer electrode contact and overall synergy, avoid local current crowding leading to efficiency loss. Core Inspection Capabilities
Detects minority carrier diffusion length, minority carrier lifetime (accuracy ±0.1μs), micro-cracks/broken grid/black spots/concentric circles and other defects.
Supports IVoc, Jo, τ, Rs Mapping quantitative analysis, automatic report generation and traceability.
Gold-plated probe design, 2~6 sets adjustable, adaptable to different grid line spacings.
Non-contact, non-destructive inspection, suitable for both laboratory R&D and mass production quality control.
Crystalline Si · Perovskite · Tandem Full Scenario Coverage
University Research · Corporate R&D · Production Line QC · Finished Product Grading
Dual-Mode Imaging · Synchronous Analysis Quantitative Mapping · Full Defect Recognition
Applications
×
| Your name * | |
| Your call * | |
| Company name | |
| EMAIL * | |
| What are your requirements |
- product PV-Station-Solutions PV-Panel-Testing-Solutions Silicon-Ingot-Testing-Solutions
- Applications
- news
- LINKS
contact
Be the first to know about our new product launches, latest blog posts and more.
 Nanjing Vision Potential Intelligent Technology Co.,Ltd.Established based on the Nanjing Xiangning Artificial Intelligence Research Institute, we have brought together a number of outstanding industry...
Nanjing Vision Potential Intelligent Technology Co.,Ltd.Established based on the Nanjing Xiangning Artificial Intelligence Research Institute, we have brought together a number of outstanding industry...
Any question or request?
Click below, we’ll be happy to assist. contact
Copyright © 2012-2023. All Rights reserved
 关注
关注

 联系
联系
+86 15950489233
[ 联系](tel:+86 15950489233)
联系](tel:+86 15950489233)
 顶部
顶部
